Твердотельная электроника. Учебное пособие.
3.7. Флуктуации поверхностного потенциала в МДП-структурах
3.7.1. Виды флуктуаций поверхностного потенциала
Предыдущее рассмотрение электрофизических процессов в МДП-структурах неявно предполагало, что такие параметры, как величина встроенного заряда Qox, толщина подзатворного диэлектрика dox, концентрация легирующей примеси ND,A, являются одинаковыми в каждом поперечном сечении МДП-структуры. В связи с этим величина поверхностного потенциала ψs, определяемая уравнением электронейтральности
 (3.121)
(3.121)постоянна в каждой точке на поверхности полупроводника вдоль границы раздела полупроводник - диэлектрик.
В реальном случае, вследствие неконтролируемых технологических особенностей обработки поверхности полупроводника и получения подзатворного диэлектрика, величина встроенного заряда Qox, толщина диэлектрика dox, концентрация примеси ND,A могут меняться или, иначе говоря, флуктуировать от точки к точке вдоль границы раздела полупроводник - диэлектрик. Согласно уравнению электронейтральности, это вызовет при данном напряжении на затворе VG различные значения величины поверхностного потенциала ψs вдоль границы раздела. Изменение величины поверхностного потенциала ψs вдоль области пространственного заряда полупроводника при фиксированном значении напряжения на затворе VG вследствие флуктуации электрофизических характеристик МДП-структур называется флуктуациями поверхностного потенциала [22].
В том случае, когда пространственный масштаб флуктуаций характеристик МДП-структур велик и обусловлен технологическими причинами, флуктуации поверхностного потенциала называются технологическими. Очевидно, что величина и функция распределения флуктуаций потенциала в этом случае обусловлены конкретным видом флуктуаций того или иного параметра МДП-структур. Крупномасштабные флуктуации потенциала - это флуктуации с размерами, существенно превышающими характерные поперечные размеры МДП-структуры - толщину диэлектрика dox и ширину области пространственного заряда W.
В этом случае реальную МДП-структуру можно разбить на малые, параллельно соединенные МДП-конденсаторы, внутри которых значение потенциала ψs постоянно. К каждому из таких МДП-конденсаторов применимо уравнение электронейтральности (3.121). Приведенная модель была предложена в работе и получила название конденсаторной модели Гоетцбергера.
В МДП-структурах также существует другой тип флуктуаций поверхностного потенциала, обусловленный дискретностью элементарного заряда. Так, при плотности встроенного в окисел заряда Nox = 1012 см-2 среднее расстояние между зарядами составляет a = 100 A. При концентрации легирующей примеси ND = 1015 см-3 доноры расположены друг от друга на среднем расстоянии a = 1000 A. Очевидно, что в силу случайного характера расположения этих зарядов, их дискретности величина поверхностного потенциала будет также флуктуировать вдоль границы раздела полупроводник - диэлектрик. Флуктуации такого типа характеризуются более мелким масштабом и называются статистическими. К статистическим флуктуациям неприменимо уравнение электронейтральности в виде (3.121).
Технологические крупномасштабные флуктуации поверхностного потенциала можно наблюдать непосредственно в экспериментах со ртутным сканирующим зондом.

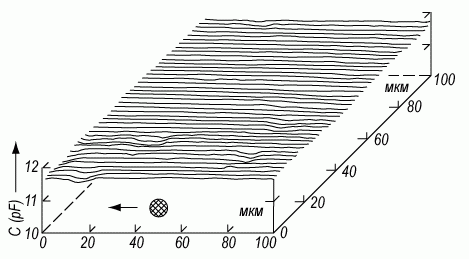

Рис. 3.22. Зависимость емкости МДП-структуры:
а) в обеднении, иллюстрирующая неоднородность поверхностного потенциала; б) в обогащении, иллюстрирующая неоднородность толщины подзатворного диэлектрика dox; в) в сильной инверсии, иллюстрирующая однородное распределение концентрации легирующей примеси в полупроводниковой подложке.
Пики соответствуют центрам повышенной (аномальной) генерации.
На рисунке 3.22 приведена в качестве примера зависимость емкости МДП-структуры в обеднении, полученная при сканировании ртутным зондом площадки размером (0,1x0,1) мм2 в системе двуокись кремния - кремний. Из рисунка видно, что значения емкости C, а следовательно, и поверхностного потенциала ψs, отличаются от точки к точке.Статистические флуктуации в силу их мелкомасштабности нельзя непосредственно измерить и наблюдать в экспериментах с ртутным зондом. Однако они будут проявляться в экспериментах с исследованием процессов переноса в инверсионных каналах вдоль границы раздела полупроводник - диэлектрик, в поведении емкости C и нормированной проводимости G МДП-структур.
Основной задачей при рассмотрении флуктуаций поверхностного потенциала является нахождение функции распределения поверхностного потенциала ψs и учет влияния флуктуаций ψs на электрофизические процессы в МДП-структурах.
3.7.2. Конденсаторная модель Гоетцбергера для флуктуаций поверхностного потенциала
Пусть флуктуации поверхностного потенциала обусловлены крупномасштабными технологическими флуктуациями плотности встроенного в диэлектрик заряда Qox = qNox. Толщина подзатворного диэлектрика dox и концентрация легирующей примеси ND,A, как видно из рисунка 3.22а, б, остается постоянной.
Рассмотрим, каким образом можно получить функции распределения P(ψs) поверхностного потенциала ψs вдоль границы раздела полупроводник - диэлектрик. Пусть N - среднее число заряженных центров на границе раздела полупроводник - диэлектрик, приходящееся на характеристическую площадку αs. Под характеристической площадкой αs будем понимать ту минимальную площадь, на которую можно разбить МДП-структуру, чтобы в пределах этой площадки величина поверхностного потенциала была одинакова. Если N - большое число, то функция P(N) будет гауссовской аппроксимацией распределения Пуассона:
 (3.122)
(3.122)Величина N и плотность заряда Qox на площадке αs связаны очевидным соотношением:
 (3.123)
(3.123)Комбинируя (3.122) и (3.123), получаем для функции распределения плотности заряда P(Qox):
 (3.124)
(3.124)Для функции распределения поверхностного потенциала имеем:
 (3.125)
(3.125)
Продифференцировав уравнение электронейтральности в виде (3.121) и учитывая, что  , qNss = Css, а также, что величина dVG = 0, так как напряжение VG одинаково для каждой характеристической площадки αs, получаем:
, qNss = Css, а также, что величина dVG = 0, так как напряжение VG одинаково для каждой характеристической площадки αs, получаем:
 (3.126)
(3.126)где Qox, ψs - среднее значение заряда Qox и поверхностного потенциала ψs.
Подставляя в уравнение (3.125) для функции распределения P(ψs) соотношения (3.126) и (3.124), имеем:
 (3.127)
(3.127)
где величина относительной среднеквадратичной флуктуации потенциала  равняется:
равняется:
 (3.128)
(3.128)Среднеквадратичная флуктуация потенциала σψ, определяющая отклонение ψs от среднего значения ψs, будет равна:
 (3.129)
(3.129)Из соотношения (3.128) следует, что флуктуации потенциала описываются в конденсаторной модели нормальным распределением. Величина среднеквадратичной флуктуации потенциала определяется толщиной диэлектрика dox, плотностью поверхностных состояний Nss, величиной средней плотности заряженных центров Qox на границе раздела. Величина ψs, входящая в (3.128), в рассмотрении точно не определена. Сравнение теоретического рассмотрения конденсаторной модели с экспериментом по анализу кривых нормированной проводимости Gp/ω показало, что величина площадки αs равна в области обеднения МДП-структуры квадрату ширины обедненной области (рис. 3.23).

Рис. 3.23. Зависимость площадки αs от ширины области обеднения W
3.7.3. Среднеквадратичная флуктуация потенциала, обусловленная системой случайных точечных зарядов
Рассмотрим систему зарядов на бесконечной плоскости, координата каждого из которых является случайной функцией. Заряды будем считать малыми и находящимися в узлах со средним расстоянием между узлами ã. Плотность узлов N0 = ã-2 значительно больше, чем средняя плотность зарядов Ñox. Вероятность заполнения одного узла α << 1 и равна α = Ñox/N0.
Потенциал, который создает произвольный узел в некоторой точке A на расстоянии  от него, будет равен:
от него, будет равен:
 (3.130)
(3.130)
где Ui - потенциал, создаваемый заряженным узлом в точке A,
ρ - расстояние в плоскости от начала координат до заряда,
λ - расстояние от точки A, где ищется потенциал, до плоскости, где расположены заряды.
Средняя величина потенциала Vi, создаваемого i-м узлом, по определению среднего,
 (3.131)
(3.131)Для расчета среднеквадратичного отклонения запишем:

Тогда среднеквадратичное отклонение величины Vi будет равно:
 (3.132)
(3.132)учитывая, что α << 1.
Потенциал U, создаваемый всей совокупностью зарядов на плоскости в точке A с координатами (ρ, λ), будет равен:
 (3.133)
(3.133)где Ni - число узлов на расстоянии ri,
ni - число заполненных узлов на расстоянии ri.
Учитывая, что заполнение и расположение узлов является случайным, для величины среднеквадратичного отклонения потенциала в точке A с координатами (ρ, λ), обусловленного всеми зарядами, получаем, учитывая (3.133),
 (3.134)
(3.134)Рассмотрим количество узлов Ni в интервале (ρ, ρ+dρ) около точки A. Оно будет:
 (3.135)
(3.135)Учитывая определение вероятности заполнения узла α и (3.134), из (3.135) получаем:
 (3.136)
(3.136)В полученном выражении величина Ui(ρ, λ) имеет смысл потенциала единичного точечного заряда. Таким образом, из (3.136) можно видеть, что величина среднеквадратичной флуктуации потенциала σU, вызванной системой точечных зарядов, определяется только их плотностью и потенциалом одного такого заряда.
3.7.4. Потенциал, создаваемый зарядом, находящимся на границе двух сред с экранировкой
Как было показано, величина среднеквадратичной флуктуации потенциала σψ определяется потенциалом единичного точечного заряда при случайном их распределении. В связи с этим интересно рассмотреть зависимость этого потенциала от условий экранировки, которые обычно реализуются в МОП-структурах. Для области слабой инверсии, когда в ОПЗ полупроводника отсутствуют свободные носители, эту область можно рассматривать как диэлектрическую среду с относительной диэлектрической проницаемостью εs.
Точечный пробный заряд поместим на границу раздела окисел - полупроводник. Поскольку величины диэлектрической проницаемости полупроводника εs и окисла εox различны, необходимо учесть различную поляризацию зарядом этих сред аналогично. И наконец, отраженный в металлическом электроде затвора заряд будет также оказывать свое влияние на поляризацию полупроводника и окисла. Ширину ОПЗ W будем считать существенно большей, чем толщина диэлектрика dox, с тем, чтобы исключить экранировку пробного заряда полупроводником. Экранировку потенциала заряда поверхностными состояниями также будем считать отсутствующей.
Поле заряда, расположенного под границей двух диэлектриков
Рассмотрим случай экранировки зарядов на рисунке 3.24. Заряд q0 расположен в среде I с диэлектрической постоянной ε = ε1. Требуется найти поле, создаваемое зарядом q0 в среде II с диэлектрической постоянной ε = ε2. Оказывается, что в общем случае невозможно подобрать систему зарядов, которые бы давали одновременно правильное значение поля и потенциала одновременно в обеих средах I и II. Поэтому поле в среде I будем искать как поле двух зарядов q1 и q2, а поле в среде II - как поле заряда q3, расположенного в той же точке, что и заряд q1. Конечно, физически существует только заряд q0, поле и потенциалы в средах I и II получаются из-за поляризации диэлектриков. Однако оказывается, что подход с введением фиктивных зарядов q1, q2 и q3 удобен и позволяет правильно рассчитывать распределение полей и потенциалов в сложных слоистых системах. Выберем величину заряда q2 = -αq1, разницу в величинах ε1, ε2 включим в множитель α. Тогда получим выражения для нормальной (En) и тангенциальной (Eτ) составляющих электрического поля, изображенных на рисунке 3.24.
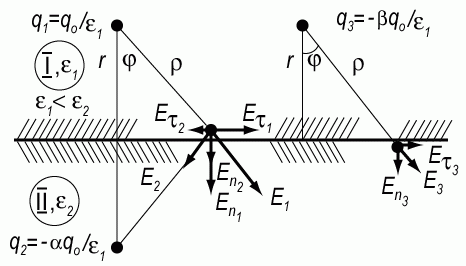
Рис. 3.24. Схема, поясняющая экранировку зарядов границей раздела двух диэлектриков
Сверху границы в области I, где поле определяется зарядами q1 и q2, находящимися на на расстоянии τ от границы в среде с диэлектрической проницаемостью ε1,
 (3.137)
(3.137)Снизу границы в области II, где поле определяется зарядом q3 в среде с ε1,
 (3.138)
(3.138)Используя условие постоянства на границе двух диэлектрических сред тангенциальной составляющей напряженности электрического поля Ez1,2 = Ez3 и нормальной составляющей индукции электрического поля ε1En1,2 = ε2En3, получаем:
 (3.139)
(3.139)где εот = ε2/ε1.
Отсюда следует, что
 (3.140)
(3.140)Таким образом, для правильного рассмотрения электрического поля и потенциала, создаваемого зарядом q0 в среде I с ε1 и находящегося под границей со средой II с ε2, необходимо при расчете поля в среде I с диэлектрической постоянной ε1 пользоваться зарядами q1 и q2, расположенными равноудаленно от границы раздела. Величина q2 = -αq1, где α приведена в (3.140). Для расчета поля в среде II с диэлектрической постоянной ε2 необходимо пользоваться зарядом q3 = βq1, расположенным на месте заряда q1 в среде I с диэлектрической постоянной ε1.
Потенциал заряда в МДП-структуре
Рассмотрим случай, когда точечный заряд находится на границе раздела окисел - полупроводник. Экранировка происходит только затвором структуры (слабая инверсия, низкая плотность поверхностных состояний, стандартное легирование). На рисунке 3.25 изображена возникшая ситуация. Рассмотрим случай, когда нужно сначала рассмотреть поле в окисле структуры. Заряд q, находящийся на границе, отразится зеркально затвором -q, но в этом случае заряд -q - это заряд над границей двух диэлектриков. Из-за поляризации для получения правильного поля в окисле необходимо ввести заряд αq, находящийся по другую сторону на таком же расстоянии от границы раздела. Этот заряд αq в свою очередь снова отразится в затворе и даст заряд -αq. Таким образом, правильное поле в окисле в случае трехслойной МДП-системы получается только при бесконечном наборе зарядов слева и справа от границы раздела.
Для расчета поля и потенциала в полупроводнике все заряды слева на рисунке 3.25 мы должны уменьшить в β раз согласно предыдущему рассмотрению. Следовательно, величина поля и потенциала в полупроводнике МДП-структуры обусловлена суммой зарядов +q и противоположного по знаку -βq, +βαq, -βα2q и т.д., отстоящих на расстояние 2dox, 4dox, 6dox, 8dox от границы раздела окисел - полупроводник.
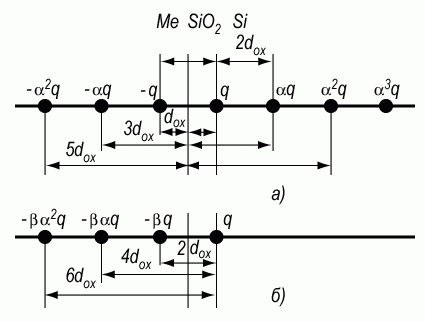
Рис. 3.25. Схема зарядов, необходимая для расчета электрического поля и потенциала МДП-структуры:
а) в диэлектрике; б) в полупроводнике
Условие электронейтральности соблюдено, заряд слева и справа суммарно равны между собой. Поскольку мы предположили, что заряд находится на границе раздела окисел-полупроводник, то

Таким образом, потенциал, создаваемый в полупроводнике точечным зарядом, находящимся на границе окисел - полупроводник при экранировке затвором МДП-структуры, на расстоянии λ вглубь и ρ в плоскости границы раздела можно вписать в виде потенциала распределенного диполя:
 (3.141)
(3.141)В случае равенства диэлектрических постоянных полупроводника и диэлектрика ε1 = ε2 = ε*, β = 1, α = 0 получаем потенциал простого диполя:
 (3.142)
(3.142)Как следует из соотношений (3.141) и (3.142), различие в потенциалах простого и рассредоточенного диполя будет проявляться при высоких различиях в диэлектрических постоянных окисла и полупроводника, большой толщине диэлектрика dox, высоких значениях (по сравнению с толщиной окисла) расстояния вглубь полупроводника λ, где рассчитывается потенциал.
3.7.5. Потенциальный рельеф в МДП-структуре при дискретности элементарного заряда
Для нахождения вида потенциального рельефа в МДП-структуре воспользуемся методом математического моделирования. Для этого, используя датчик случайных чисел, на площадке S, соответствующей в случае МДП-структуры границе раздела полупроводник - диэлектрик, разбрасываются N единичных точечных зарядов со средней плотностью Ñox = N/S. Потенциал каждого заряда рассчитывается с учетом экранировки затвором МДП-структуры по уравнению (3.141). Как и прежде, предполагается, что реализовано условие слабой инверсии или обеднения и толщина подзатворного диэлектрика dox меньше ширины ОПЗ.
Для нахождения вида потенциального рельефа потенциалы всех зарядов суммировались и из полученного значения вычиталось среднее значение величины поверхностного потенциала ψs, соответствующее квазинепрерывному и равномерному распределению встроенного заряда со средней плотностью Ñox.
На рисунке 3.26 приведена полученная таким образом картина потенциального рельефа. Из рисунка видно, что потенциальный рельеф негладкий, на нем имеются "озера" - участки со значительно меньшим уровнем поверхностного потенциала, "горные хребты" - участки со значительно большим уровнем поверхностного потенциала и, наконец, "долины" - области, где поверхностный потенциал близок к среднему. На приведенной шкале пространственного масштаба видно, что характерный размер областей "озер" и "горных хребтов" составляет порядка 500 Å при толщине диэлектрика dox в МДП-структуре dox = 50 Å.

Рис. 3.26. Форма потенциального рельефа в МДП-структуре в области слабой инверсии. Сплошные линии соответствуют отклонению потенциала ψs от среднего значения ψs на величину среднеквадратичной флуктуации σψ. Точки соответствуют местам расположения зарядов
На рисунке 3.27 приведена зависимость поверхностного потенциала ψs от координаты y вдоль границы раздела полупроводник - диэлектрик, рассчитанная для случая, приведенного на рисунке 3.26. Из данного рисунка также видно, что зависимость потенциала ψs от координаты является немонотонной функцией.
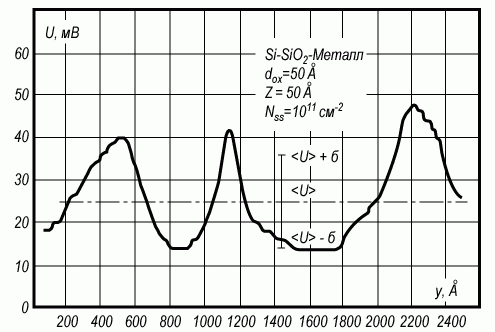
Рис. 3.27. Зависимость потенциала ψs от координаты y вдоль поверхности
Таким образом, дискретность и случайный характер расположения в плоскости границы раздела полупроводник - диэлектрик встроенного заряда вызывают флуктуации относительного среднего значения величины поверхностного потенциала.
3.7.6. Функция распределения потенциала при статистических флуктуациях
При рассмотрении флуктуаций поверхностного потенциала вопрос о нахождении вида функций распределения является одним из важных. Поскольку заряженные центры в МДП-структуре дискретны и случайным образом распределены в плоскости границы раздела, то их закон распределения описывается уравнением Пуассона:
 (3.143)
(3.143)где N - число зарядов, ожидаемое найти на площадке S, Ñ = Ñox·S - среднее число зарядов, находящееся на произвольной площадке S.
Координаты каждого заряда в плоскости ρi являются случайной функцией, а общий потенциал от всех зарядов в произвольной точке ОПЗ полупроводника на расстоянии λ будет суммой потенциалов всех точечных зарядов в виде (3.141):
 (3.144)
(3.144)В явном виде совместное решение уравнений (3.141 - 3.144) возможно только при условии λ >> dox, ã = Ñox-1/2.
В этом случае закон распределения потенциала ψs описывается гауссовым распределением:
 (3.145)
(3.145)где σs - относительная среднеквадратичная флуктуация потенциала ψs на расстоянии λ. Поскольку в общем виде соотношения (3.141 - 3.144) не представляется возможным решать в аналитическом виде, для нахождения функции распределения P(ψs) использовалось численное моделирование, аналогичное описанному в разделе 3.7.5. Генерируя n раз датчиком случайных чисел координаты всех зарядов, рассчитывалось в произвольной, заранее выбранной точке значение суммарного потенциала. Частота выпадания того или иного значения потенциала соответствовала плотности вероятности.
На рисунке 3.28 показан вид функции распределения поверхностного потенциала ψs для МДП-структур с различной толщиной подзатворного диэлектрика в диапазоне dox = (50÷1000) Å. Заметим, что функции не нормированы.

Рис. 3.28. Вид функции распределения f потенциала в МДП-структурах с разной толщиной диэлектрика
Из рисунка видно, что при малых значениях толщины окисла dox функция распределения отличается от гауссовой. По мере роста толщины диэлектрика распределение потенциала приближается к нормальному.
На рисунке 3.29 показана зависимость функции распределения от средней плотности заряда Ñox на границе раздела окисел - полупроводник.

Рис. 3.29. Вид функции распределения f потенциала в МДП-структуре при разной величине плотности заряда
Также видно, что при малых плотностях Ñox функция распределения отличается от гауссовой, по мере роста числа зарядов Ñox распределение потенциала также приближается к линейному.
На рисунке 3.30 показано изменение вида функции распределения по мере приближения к границе раздела окисел - полупроводник. Видно, что средняя часть функции распределения не меняется, но "хвост" функции в сторону вероятности получения больших значений потенциала, по мере приближения к границе раздела, возрастает.
Физическая картина, обуславливающая отличие вида функции распределения поверхностного потенциала ψs от нормального распределения, заключается в том, что потенциал кулоновского точечного центра резко зависит от расстояния r при малых значениях r.
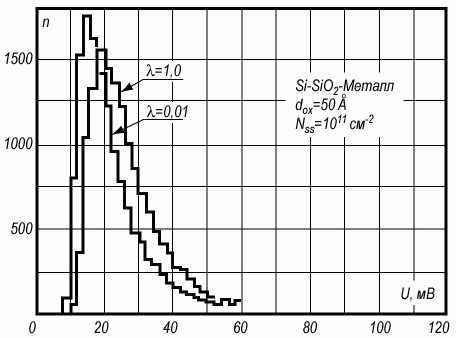
Рис. 3.30. Вид функции распределения f потенциала в МДП-структуре при различных расстояниях λ вглубь полупроводника
3.7.7. Зависимость величины среднеквадратичной флуктуации от параметров МДП-структуры
Как следует из разделов 3.7.3 и 3.7.4, для случая слабой инверсии можно получить зависимость величины среднеквадратичной флуктуации от параметров МДП-структуры. Подставим значение для потенциала единичного заряда U(ρ, λ) в виде (3.142) в выражение (3.136) для величины среднеквадратичной флуктуации потенциала σψ. Для случая ε1 = ε2 = ε* интеграл (3.142) с выражением U(ρ, λ) в виде (3.136) берется в явном виде и получаем:
 (3.146)
(3.146)Когда диэлектрические постоянные окисла и полупроводника εox и εs сильно отличаются друг от друга, зависимость σψ(λ, dox) в аналитическом виде не выражается.
На рисунке 3.31 приведены расчетные зависимости величины средне-квадратичной флуктуации потенциала σψ(λ) при различных толщинах подзатворного диэлектрика. Обращает на себя внимание тот факт, что в случае статистических флуктуаций величина среднеквадратичного отклонения σψ довольно значительно зависит от расстояния λ вглубь полупроводника. По мере уменьшения толщины подзатворного диэлектрика зависимость σψ(λ) увеличивается. Видно также, что чем тоньше подзатворный диэлектрик, тем сильнее экранируются флуктуации и тем меньше величина среднеквадратичной флуктуации потенциала.

Рис. 3.31. Зависимость величины среднеквадратичной флуктуации σψ от расстояния λ вглубь полупроводника, рассчитанная при различных величинах толщины диэлектрика dox
Из соотношения (3.146) следует, что по мере приближения к границе раздела при λ → 0 величина среднеквадратичной флуктуации σψ логарифмически стремится к бесконечности. Этот факт обусловлен тем, что потенциал точечного заряда при r → 0 стремится к бесконечности. Как уже отмечалось в предыдущем разделе, функция распределения потенциала P(ψs) в этом случае имеет длинный "хвост" в сторону вероятности нахождения больших значений потенциала. Очевидно, что бесконечных значений потенциала на границе раздела не существует. Физическим ограничением на расстояние λ, на которое носители могут приблизиться к заряженному центру, является его конечный размер. Различные оценки приводят к величине ρmin = (5÷100) Å в интеграле (3.136) и соответствующей замене нижнего предела интегрирования с нуля на величину ρmin.
При расчете среднеквадратичной флуктуации σψ(λ, dox) с использованием значения потенциала U(ρ, λ) в виде распределенного диполя по уравнению (3.141) и дальнейшего численного расчета интеграла σψ(λ, dox) по уравнению (3.136) получено незначительное расхождение между значениями среднеквадратичной флуктуации по сравнению с сосредоточенным диполем только в области малых значений λ. Это позволяет в дальнейшем использовать для расчетов зависимости σψ(λ, dox) явное выражение в виде (3.152).
Рассмотрев зависимость величины среднеквадратичной флуктуации σψ от параметров МДП-структуры применительно к переносу заряда в инверсионном канале, Брюс получил аналогичную зависимость в виде:
 (3.147)
(3.147)где Cox, Css, Csc - удельная емкость окисла, поверхностных состояний и полупроводника,
λ - среднее расстояние носителей в инверсионном слое до поверхности.
Выражение (3.147) для σψ было получено Брюсом из решения уравнения Пуассона с использованием функций Грина. Для областей слабой инверсии выражение (3.147) принимает вид:
 (3.148)
(3.148)Для случая λ >> dox выражения (3.148) и (3.146) дают одинаковое функциональное поведение зависимости σψ ~ λ-1 и отличаются по величине в 21/2 раз. В области малых величин λ ~ dox зависимости σψ(λ) также несколько отличаются.
3.7.8. Пространственный масштаб статистических флуктуаций
Рассмотрим, какой характерный пространственный масштаб имеют статистические флуктуации поверхностного потенциала в МДП-структурах. Пусть на границе раздела полупроводник - диэлектрик находятся точечные заряженные центры с поверхностной плотностью Nox. В силу случайного характера их расположения в плоскости границы раздела распределение зарядов задается уравнением Пуассона. Если мы разобьем плоскость границы раздела на произвольные площадки с размером L, то на одних площадках зарядов будет больше, на других - меньше. Это эквивалентно тому, что наряду с плоскостью, заряженной равномерно, имеется дополнительный набор положительно и отрицательно заряженных площадок. Ситуация будет чем-то напоминать шахматную доску с чередующимися белыми и черными полями. Необходимо рассмотреть, как будет вести себя потенциал такой знакопеременной системы зарядов.
Будем считать за плотность заряда σ на таких площадках избыточную, по сравнению со средней, плотность заряда, обусловленную случайным распределением заряженных центров на поверхности.
Величина σ будет равна:
 (3.149)
(3.149)При пуассоновском распределении точечных зарядов на плоскости величина среднеквадратичного отклонения ΔN равна
 (3.150)
(3.150)где N - среднее число зарядов на площадке S с размерами L,
Ñox - средняя плотность зарядов на единицу площади.
Рассмотрим, чему равен потенциал заряженной плоскости с линейным размером L. Элементарное интегрирование даст, что потенциал U, создаваемый заряженной плоскостью на расстоянии λ вглубь полупроводника на нормали, проходящей через ее центр, будет:
 (3.151)
(3.151)Величина потенциала U0 на плоскости при λ = 0 будет:
 (3.152)
(3.152)Как следует из уравнений (3.151) и (3.152), величина потенциала U0 на границе раздела полупроводник - диэлектрик пропорциональна U0 ~ σL. Тогда с учетом (3.149) и (3.150) имеем для статистических флуктуаций:
 (3.153)
(3.153)Из соотношения (3.153) следует, что при пуассоновском распределении заряда в плоскости границы раздела полупроводник - диэлектрик величина флуктуации потенциала на поверхности U0 не зависит от масштаба флуктуаций L, а определяется только средней плотностью заряда Ñox.
Для выявления особенностей экранировки потенциала знакопеременной системы зарядов рассмотрим модельную задачу. Пусть на границе раздела полупроводник - диэлектрик распределен заряд с плотностью σ(x, y), изменяющейся по гармоническому закону:
 (3.154)
(3.154)Для нахождения потенциала, создаваемого в полупроводнике такой системой зарядов, запишем уравнение Пуассона в виде:
 (3.155)
(3.155)где ρ(x, y, z) - объемная плотность заряда.
Решение уравнения Пуассона приводит к следующему значению потенциала φ(x, y, z):
 (3.156)
(3.156)где L - линейный масштаб одной ячейки,
λ - расстояние от границы раздела вглубь полупроводника до точки, где рассчитывается потенциал.
Вследствие экранировки заряда, находящегося на границе раздела полупроводник - диэлектрик металлическим затвором МДП-структуры, за счет сил зеркального отражения в затворе возникает потенциал Uотр, описываемый в полупроводнике соотношением:

Суммарный потенциал в полупроводнике с учетом экранировки, как показано на рисунке 3.32, будет равен:
 (3.157)
(3.157)На рисунке 3.32 приведена зависимость потенциала U(x, y, z) от расстояния λ вглубь полупроводника, рассчитанная по уравнению (3.157).
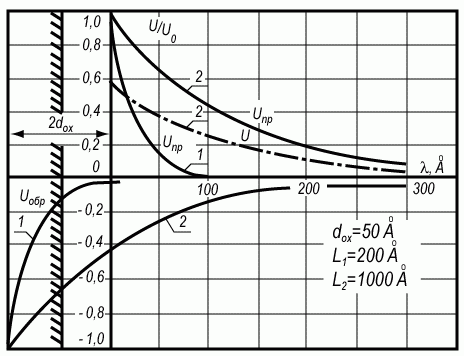
Рис. 3.32. Зависимость потенциала U/U0 знакопеременной системы зарядов типа "шахматная доска" от расстояния λ вглубь полупроводника с учетом экранировки затвором МДП-структуры
На рисунке 3.33 приведен закон спада потенциала вглубь полупроводника в зависимости от масштаба L. Как следует из этого рисунка, мелкомасштабные флуктуации на больших расстояниях экранируются эффективнее, чем крупномасштабные.

Рис. 3.33. Потенциал U/U0 системы зарядов типа "шахматная доска" в зависимости от расстояния λ вглубь полупроводника:
dox = 50A, 1 - L = 100A, 2 - L = 1000A, 3 - L = 10000A,
dox = 1000A, 4 - L = 100A, 5 - L = 1000A, 6 - L = 10000A
На рисунке 3.34 показан характер экранировки потенциала в зависимости от масштаба L при разных толщинах подзатворного диэлектрика dox и различных расстояниях λ.

Рис. 3.34. Зависимость потенциала U/U0 системы зарядов типа "шахматная доска" от размера L при различных толщинах окисла dox и расстояниях λ вглубь полупроводника
Видно, что зависимость потенциала U от масштаба L имеет выраженный максимум. Исследование соотношения (3.157) на экстремум показывает, что оптимальная величина масштаба Lопт, соответствующая максимальному значению потенциала (U/U0)max, будет равна:
 (3.158)
(3.158)На рисунке 3.35 приведена зависимость масштаба Lопт, рассчитанная по соотношению (3.158) от толщины диэлектрика при разных расстояниях вглубь полупроводника.
При больших значениях толщины диэлектрика оптимальный масштаб имеет размеры порядка толщины диэлектрика Lопт ~ dox, при малых толщинах диэлектрика величина оптимального масштаба существенно больше толщины диэлектрика Lопт >> dox.
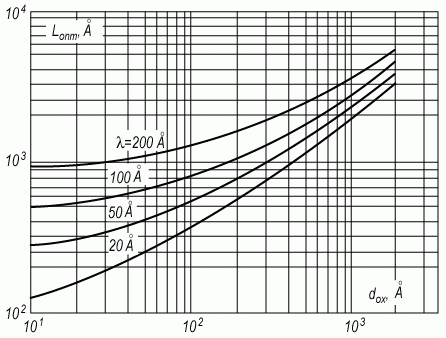
Рис. 3.35. Зависимость оптимального масштаба Lопт, соответствующему максимальному значению относительного потенциала U/U0, от толщины подзатворного диэлектрика dox
3.7.9. Сравнительный анализ зависимости среднеквадратичной флуктуации σψ и потенциала оптимальной флуктуации
Представляет определенный интерес сравнение спада потенциала U(λ), рассчитанного по соотношению (3.157) для флуктуаций различного масштаба L, со спадом величины среднеквадратичной флуктуации σψ(λ). Воспользуемся тем фактом, что для различных масштабов L величина потенциала на поверхности U0 будет одинакова, как было показано в уравнении (3.123). Будем также учитывать для каждого значения расстояния λ только оптимальные флуктуации, дающие максимальное значение потенциала, то есть флуктуации размером L = Lопт, рассчитанным по (3.158). Величину U0 выберем для всех случаев такую, чтобы для одной из толщин диэлектрика значения σψ и потенциала U совпали бы при больших значениях λ → ∞.
При других значениях толщины диэлектрика такое совпадение наблюдалось автоматически.
На рисунке 3.36 приведен график потенциала оптимальной флуктуации, рассчитанный подобным образом. Из графика видно, что при больших λ наблюдается совпадение характера зависимости среднеквадратичной флуктуации σψ и потенциала оптимальной флуктуации U от расстояния λ вглубь полупроводника.
Расхождение наблюдается при малых значениях λ, причем с уменьшением толщины диэлектрика dox область значения λ, где наблюдается это расхождение, также уменьшается. При значениях λ → 0, то есть при приближении к границе раздела полупроводник - диэлектрик, величина среднеквадратичной флуктуации σψ логарифмически расходится, в то время как потенциал оптимальной флуктуации имеет конечное значение, равное U0.
Зависимость величины потенциала флуктуации U от масштаба L приведена ранее на рисунке 3.34. При пуассоновском характере распределения точечных зарядов очевидно, что должна наблюдаться минимальная величина масштаба флуктуации, определяемая средним расстоянием между заряженными точечными центрами.
 (3.159)
(3.159)Для Ñox = 1010см-2 величина Lmin будет порядка 1000A,
для Ñox = 1012см-2 величина Lmin будет порядка 100A.
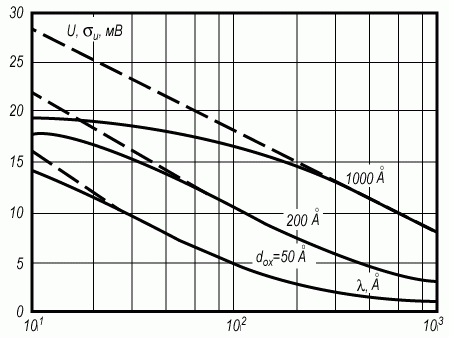
Рис. 3.36. Зависимость потенциала оптимальной флуктуации U0 и величины среднеквадратичной флуктуации σU от расстояния λ вглубь полупроводника для системы случайно распределенных точечных зарядов на границе раздела окисел - полупроводник
Таким образом, дискретность зарядов на границе раздела полупроводник - диэлектрик является физической причиной ограничения минимального масштаба флуктуации. Физическое ограничение максимального масштаба флуктуаций определяется размерами исследуемой МДП-структуры: Lmax ≈ Lобр.
Таким образом, на границе раздела окисел - полупроводник возможны все масштабы флуктуаций заряда от Lmin до Lmax. Но в силу экранировки затвором во флуктуации потенциала дают максимальный вклад такие масштабы, которые удовлетворяют соотношению (3.158). В данном случае МДП-структура выступает чем-то в виде RC-фильтра, который из набора сигналов всех гармоник выделяет преимущественно одну частоту.
При переходе от области слабой к области сильной инверсии начинает играть свою роль экранирование свободными носителями. В некотором смысле это эквивалентно установке и приближению к границе второго затвора со стороны полупроводниковой подложки. Учтем этот факт экранировки следующим образом. Введем расстояние dnn из условия равенства емкостей области пространственного заряда Csc и емкости конденсатора с диэлектрической проницаемостью εs и расстоянием между обкладками dnn. Получаем:
 (3.160)
(3.160)Величина dnn для области сильной инверсии будет эквивалентна среднему расстоянию свободных носителей в области пространственного заряда до границы раздела полупроводник - диэлектрик. С ростом избытка свободных носителей в инверсионном канале Γp,n величина dnn будет уменьшаться и, как следует из рисунка 3.36, будет происходить экранировка флуктуаций сначала больших масштабов. При этом будет уменьшаться и абсолютная величина флуктуаций потенциала, как видно из рисунка 3.36, и потенциальный рельеф будет становиться все мелкомасштабнее.
Максимальная длина свободного пробега дырок в инверсионных каналах кремниевых МДП-структур, рассчитанная из значения подвижности в максимуме зависимости μ(Γp) при температурах T = (77÷350)°К, составляет величину не более λ = (200÷300) A.
Величина линейного масштаба оптимальной флуктуации, как видно из рисунка 3.35, во всех случаях обычно больше длины свободного пробега, в том числе и в МДП-структурах со сверхтонким подзатворным диэлектриком. Этот факт позволяет рассматривать процесс переноса свободных носителей заряда в сложном потенциальном рельефе в инверсионных каналах МДП-структур как процесс "протекания" в случайном потенциальном поле, а не как процесс рассеяния.
Copyright © 2003-2008 Авторы


 Физика поверхности и МДП-структуры - Флуктуации поверхностного потенциала в МДП-структурах
Физика поверхности и МДП-структуры - Флуктуации поверхностного потенциала в МДП-структурах