Твердотельная электроника. Учебное пособие.
4.3. Влияние генерации, рекомбинации и объемного сопротивления базы на характеристики реальных диодов
В реальных выпрямительных диодах на основе p-n перехода при анализе вольт-амперных характеристик необходимо учитывать влияние генерационно-рекомбинационных процессов в обедненной области p-n перехода и падение напряжения на омическом сопротивлении базы p-n перехода при протекании тока через диод.
При рассмотрении влияния генерационно-рекомбинационных процессов в ОПЗ p-n перехода будем считать, что доминирующим механизмом генерационно-рекомбинационного процесса является механизм Шокли - Рида. В этом случае для моноэнергетического рекомбинационного уровня, расположенного вблизи середины запрещенной зоны полупроводника, выражение для темпа генерации (рекомбинации) имеет вид:
 (4.6)
(4.6)Параметры, входящие в соотношение 4.10, имеют следующие значения:
γn, γp - вероятности захвата электронов и дырок на рекомбинационный уровень;
Nt - концентрация рекомбинационных уровней;
n, p - концентрации неравновесных носителей;
n1, p1 - концентрации равновесных носителей в разрешенных зонах при условии, что рекомбинационный уровень совпадает с уровнем Ферми.
Из уравнений 4.6 и 1.20 следует, что при прямом смещении (VG > 0) произведение концентрации неравновесных носителей p·n будет больше, чем произведение концентрации равновесных носителей p1·n1 (p·n > p1·n1). Следовательно, правая часть уравнения 4.6 будет положительная, а скорость изменения концентрации неравновесных носителей dn/dt будет отрицательной. Таким образом, концентрация неравновесных носителей будет убывать и рекомбинация будет преобладать над генерацией.
При обратном смещении (VG < 0) соотношения будут обратными, концентрация неравновесных носителей будет возрастать и генерация будет преобладать над рекомбинацией. Рассмотрим более подробно эти процессы.
4.3.1. Влияние генерации неравновесных носителей в ОПЗ p-n перехода на обратный ток диода
При обратном смещении (VG < 0) p-n перехода из соотношения 1.20 следует, что

Величина произведения концентрации равновесных носителей p1·n1 будет равна квадрату собственной концентрации: p1n1 = ni2.
В этом случае из уравнения 4.6 следует, что

Учтем, что значения концентрации неравновесных носителей p, n будут меньше концентрации равновесных носителей p1 и n1: p < p1, n < n1, а величины n1 и p1 определяются через объемное положение уровня Ферми φ0t следующим образом:

Тогда получаем:

где τe - эффективное время жизни неравновесных носителей, определяемое как
 (4.8)
(4.8)Из соотношения 4.7 следует, что скорость изменения концентрации неравновесных носителей dn/dt будет положительной, следовательно, генерация будет преобладать над рекомбинацией. Для того чтобы рассчитать генерационный ток Jген, необходимо проинтегрировать по ширине области пространственного заряда W:
 (4.9)
(4.9)Рассмотрим зависимость генерационного тока Jген от обратного напряжения VG, приложенного к диоду, а также от температуры T (рис. 4.5).
Зависимость генерационного тока Jген от напряжения VG будет определяться зависимостью ширины области пространственного заряда W от напряжения VG. Поскольку ширина области пространственного заряда W определяется как  , то генерационный ток Jген будет пропорционален корню из напряжения: Jген ∼ VG1/2.
, то генерационный ток Jген будет пропорционален корню из напряжения: Jген ∼ VG1/2.
Величина дрейфовой компоненты обратного тока J0 несимметричного p+-n перехода равна:

Сделаем оценку отношения теплового J0 и генерационного Jген токов для диодов, изготовленных из различных полупроводников:
 (4.10)
(4.10)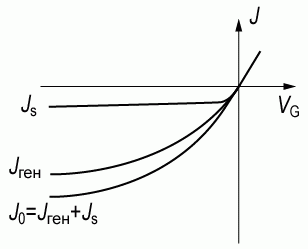
Рис. 4.5. Вклад генерационного тока Jген в обратный ток p-n перехода
Для германия (Ge) характерны следующие параметры: W = 1 мкм; Ln = 150 мкм, ni = 1013 см-3, ND = 1015 см-3. Подставляя эти величины в соотношение 4.10, получаем, что генерационный ток и тепловой ток одинаковы, Iген ~ Is.
Для кремния (Si) характерны следующие параметры: W = 1 мкм; Ln = 500 мкм, ni = 1010 см-3, ND = 1015 см-3. Подставляя эти величины в соотношение 4.10, получаем, что генерационный ток много больше, чем тепловой ток, Iген / Is ~ 2·102.
Таким образом, для кремниевых диодов на основе p-n перехода в обратном направлении преобладает генерационный ток, а для германиевых диодов - тепловой ток.
Как следует из уравнения 4.10, соотношения генерационого и теплового токов зависят от собственной концентрации ni. Если собственная концентрация ni мала (широкозонный полупроводник), - преобладает генерационный ток, если значение ni велико (узкозонный полупроводник), - преобладает тепловой ток.
4.3.2. Влияние рекомбинации неравновесных носителей в ОПЗ p-n перехода на прямой ток диода
При прямом смещении (VG > 0) p-n перехода из соотношения 1.20 следует, что

Из уравнений 4.6 и 1.20 следует, что при прямом смещении (VG > 0) произведение концентрации неравновесных носителей p·n будет больше, чем произведение концентрации равновесных носителей p1·n1 (p·n > p1·n1).
Предположим, что рекомбинационный уровень Et находится посредине запрещенной зоны полупроводника Et = Ei. Тогда p1 = n1 = ni, а коэффициенты захвата одинаковы: γn = γp. В этом случае уравнение 4.6 примет вид:
 (4.11)
(4.11)Из уравнения (4.11) следует, что темп рекомбинации dn/dt будет максимален в том случае, если знаменатель имеет минимальное значение. Это состояние реализуется в той точке ОПЗ, когда квазиуровни Ферми находятся на равном расстоянии от середины запрещенной зоны, то есть расстояние φ0 n,p от середины зоны Ei до квазиуровней Fn и Fp одинаково и равно φ0 n,p = U/2 .
При этих условиях знаменатель в уравнении 4.11 будет иметь значение  .
.
Следовательно, для скорости генерации имеем:

Величина рекомбинационного тока Jрек после интегрирования по ширине области пространственного заряда W имеет вид:
 (4.12)
(4.12)Полный ток диода при прямом смещении будет складываться из диффузионной и рекомбинационной компонент:
 (4.13)
(4.13)Из (4.13) следует, что прямой ток диода можно аппроксимировать экспоненциальной зависимостью типа J ∼ exp(βU/n), в случае значения коэффициента n = 1 ток будет диффузионным, при n = 2 - рекомбинационным. На рисунке 4.6 показана зависимость тока диода от напряжения при прямом смещении в логарифмических координатах.
Из приведенных экспериментальных данных для диода следует, что тангенс угла наклона dUпр/d(ln J) равен 0,028 В, что с высокой степенью точности соответствует значению kT/q, равному 0,026 В при комнатной температуре.

Рис. 4.6. Зависимость тока диода от напряжения при прямом смещении [2, 23]
4.3.3. Влияние объемного сопротивления базы диода на прямые характеристики
База диода на основе p-n перехода обычно легирована существенно меньше, чем эмиттер. В этом случае омическое сопротивление квазинейтральных областей диода будет определяться сопротивлением базы rб, его величина рассчитывается по классической формуле: rб = ρl/S, где ρ - удельное сопротивление, l - длина базы, S - площадь поперечного сечения диода.
В типичных случаях при ρ = 1 Ом·см, l = 10-1 см, S = 10-2 см2, rб = 10 Ом.
При этом падение напряжения Uб на квазинейтральном объеме базы при протекании тока J будет равно:
 (4.14)
(4.14)Напряжение, приложенное к ОПЗ p-n перехода, в этом случае уменьшится на величину Vб. С учетом (4.14) вольт-амперная характеристика диода будет иметь вид:
 (4.15)
(4.15)Из уравнения (4.15) следует, что по мере роста прямого тока вольт-амперная характеристика p-n перехода будет вырождаться, то есть ток будет расти не экспоненциально, а более медленно, и в предельном случае на ВАХ появится омический участок.
Определим критерий вырождения, как состояние диода, при котором дифференциальное сопротивление диода станет равно либо меньше омического сопротивления базы диода:

Следовательно, величина прямого тока, при котором наступает вырождение вольт-амперной характеристики, будет равна: Iвыр = φT/rб.
Для параметров диода rб = 10 Ом; φТ = 0,025 В ток вырождения будет равен: Iвыр = 2,5 мA.
На рисунке 4.7 показана эквивалентная схема диода, где объемное сопротивление базы диода представлено в виде резистора, последовательно соединенного с идеальным диодом.

Рис. 4.7. Рисунки, иллюстрирующие влияние сопротивления базы на вольт-амперные характеристики диода при прямом смещении [17, 23, 26]:
а) эквивалентная схема диода; б) ВАХ в линейных координатах; в) ВАХ в логарифмических координатах; г) ВАХ диода 2Д925Б при различных температурах
Пунктирная и сплошная линии, описывающие вольт-амперную характеристику, как в линейных, так и полулогарифмических координатах, сдвинуты друг относительно друга по оси напряжений на величину rб·I. Для диода 2Д925Б приведены его характеристики при различных температурах, при этом отчетливо виден линейный участок на ВАХ. Таким образом, у реальных диодов омический участок на ВАХ составляет основную часть характеристики.
4.3.4. Влияние температуры на характеристики диодов
Как уже отмечалось, при прямом смещении ток диода инжекционный, большой по величине и представляет собой диффузионную компоненту тока основных носителей. При обратном смещении ток диода маленький по величине и представляет собой дрейфовую компоненту тока неосновных носителей (рис. 4.8). Зависимость тока от напряжения определяется соотношением:  .
.
Для несимметричного p-n+ перехода NA << ND концентрация неосновных носителей в p-области существенно выше, чем в n-области np0 >> pn0. Обратный ток в этом случае обусловлен дрейфовой электронной компонентой  , поскольку
, поскольку  .
.
Обратный ток диода в этом случае будет  .
.
Вблизи комнатной температуры Тк при ее небольших отклонениях можно записать:  , тогда температурная зависимость тока преобразуется к следующему виду:
, тогда температурная зависимость тока преобразуется к следующему виду:
 (4.16)
(4.16)Величина коэффициента α для различных полупроводников будет следующей: для германия αGe = 0,09 град-1 до T = 700, для кремния αSi = 0,13 град-1 до Т = 1200.
В практических случаях используют понятие температуры удвоения обратного тока диода. Соотношение (4.16) преобразуется к следующей форме, при этом
 (4.17)
(4.17)где T* = ln(2)/a - температура удвоения тока, величина этой температуры будет равна: T* = 10; 8; 7; 5, при значениях α = 0,07; 0,03; 0,1; 0,13.
Из соотношения (4.17) и значения температуры удвоения тока T* = 10 следует простое правило: обратный ток диода удваивается при увеличении температуры на каждые 10 0С.
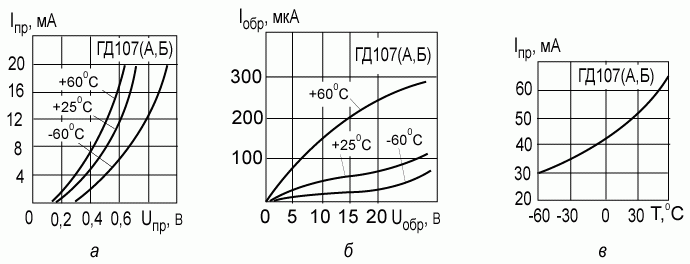
Рис. 4.8. Вольт-амперные характеристики диода ГД107 [23, 25]:
а) при прямом смещении; б) при обратном смещении; в) температурная зависимость прямого тока диода
Copyright © 2003-2008 Авторы


 Полупроводниковые диоды - Влияние генерации, рекомбинации и объемного сопротивления базы на характеристики реальных диодов
Полупроводниковые диоды - Влияние генерации, рекомбинации и объемного сопротивления базы на характеристики реальных диодов